近日,深圳大道半導體有限公司與佛山市國星半導體有限公司合作開發成功了新一代自帶導熱焊墊的大倒裝芯片級封裝(CSP)光源。
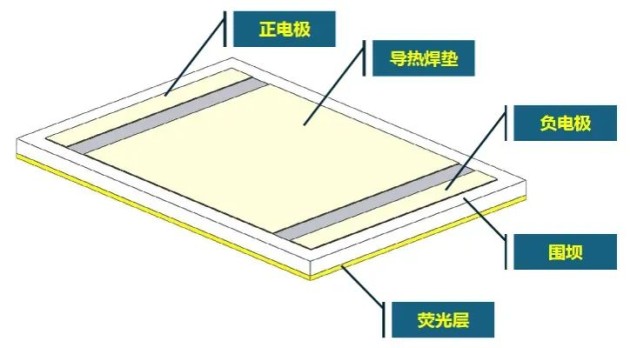
據介紹,制造傳統大功率LED光源的主要技術包括采用共晶焊接技術,把含金錫焊墊的大功率倒裝芯片共晶焊接到用DPC工藝制造的氮化鋁陶瓷基板上,在倒裝芯片四周設置圍壩和在倒裝芯片表面涂敷熒光層(包括噴涂、壓膜等工藝技術)后,再通過真空回流技術把導熱性能優異的氮化鋁陶瓷基板焊接到熱電分離銅板上。
由于金錫焊墊和氮化鋁陶瓷基板成本高,共晶焊接工藝要求苛刻,導致采用傳統大功率LED芯片和封裝結構制造的大功率LED光源價格昂貴,只能應用于高端方向性投射類照明燈具上。
該光源在結構與制造工藝上主要創新包括:
1. 自帶導熱焊墊的大功率倒裝芯片結構,具體細節發表在大道半導體名下的三項授權發明專利(201310047522.2,201310093759.4和201310307147.0)中,內容涵蓋倒裝芯片的深刻蝕側壁保護、側壁反射層、自帶導熱焊墊和倒裝芯片內三維布線結構等;
2. 不再使用價格昂貴的氮化鋁基板,單片光源厚度減少約0.4mm,應用于汽車前大燈時,可提升聚光性能,并減少暗區面積;
3. 省略了焊接工藝要求苛刻的共晶焊技術;
4. 大功率倒裝芯片不再使用價格昂貴的金錫焊墊;
5. 采用CSP封裝技術和結構,具體細節發表在大道半導體名下的二項實用新型發明專利(202020612786.3和2025204230491)以及25項外觀專利中,內容涵蓋大倒裝CSP光源和帶銅板的大倒裝CSP光源組成和結構,以及自帶導熱焊墊的大倒裝芯片外觀和大倒裝CSP光源外觀等;
6. 新一代大功率CSP光源直接真空回流焊接到熱電分離的銅線路板上。
新一代大倒裝CSP光源的整個制造工藝流程簡單,可靠,無需使用材料成本中最昂貴的金錫焊墊和氮化鋁基板,涉及的工序與設備大幅減少,也避免了工藝要求苛刻的共晶焊接,在不損失LED主要光電性能的基礎上,可以降低制造成本,為高端方向性投射類照明燈具提供了光源選擇。
此外,該產品應用高壓倒裝芯片技術,可實現6伏、9伏或更高電壓運行,無需通過芯片集成實現高電壓驅動。其結構消除了芯片拼接間隙,提高光集中度,避免暗紋,發光面積更小,從而提升中心照度與投射距離,為大功率LED在車燈及高端照明等方向性投射場景中的應用提供了可能性。
來源:大道半導體



